晶通科技亮相CFCF2025,共探光电模块先进封装新趋势!

邓先生在演讲中重点介绍了晶通科技在光电模块领域的创新应用,尤其是CPO(Co-Packaged Optics)和OIO(Optical I/O)技术。随着数据中心传输速率的不断提升,传统光模块的信号损耗问题日益突出,而CPO技术通过将光引擎与计算芯片合封,显著降低了功耗和延迟,成为未来高速数据传输的关键。晶通的光电合封解决方案覆盖从低密度到中高密度,乃至Chiplet集成的全场景需求,能够满足AI数据中心、高性能计算等领域的严苛要求。
市场趋势方面,邓先生援引权威数据指出,CPO市场正迎来爆发式增长,预计2030年市场规模将达81亿美元,年复合增长率高达137%。这一增长得益于AI大模型训练对算力的庞大需求,以及头部芯片厂商对CPO技术的加速商业化布局。晶通科技紧跟市场步伐,已推出多款光电合封产品,满足数据中心、高性能计算等领域对高速、低功耗传输的需求。
此外,在技术发展趋势方面,邓先生指出,单通道SerDes速率提升、硅光材料降本、3D异构集成将成为主流方向。然而,CPO技术仍需克服高良率实现、信号完整性保障、热管理优化等挑战。晶通科技凭借在fan-out、WLP等领域的深厚积累,正致力于突破这些技术瓶颈,推动CPO技术向更高水平发展。
此次参展CFCF2025,晶通科技不仅展示了其技术实力,更与行业同仁共谋发展,共同推动光电模块产业的创新升级。未来,晶通科技将继续深耕先进封装领域,为光电模块产业注入新活力。
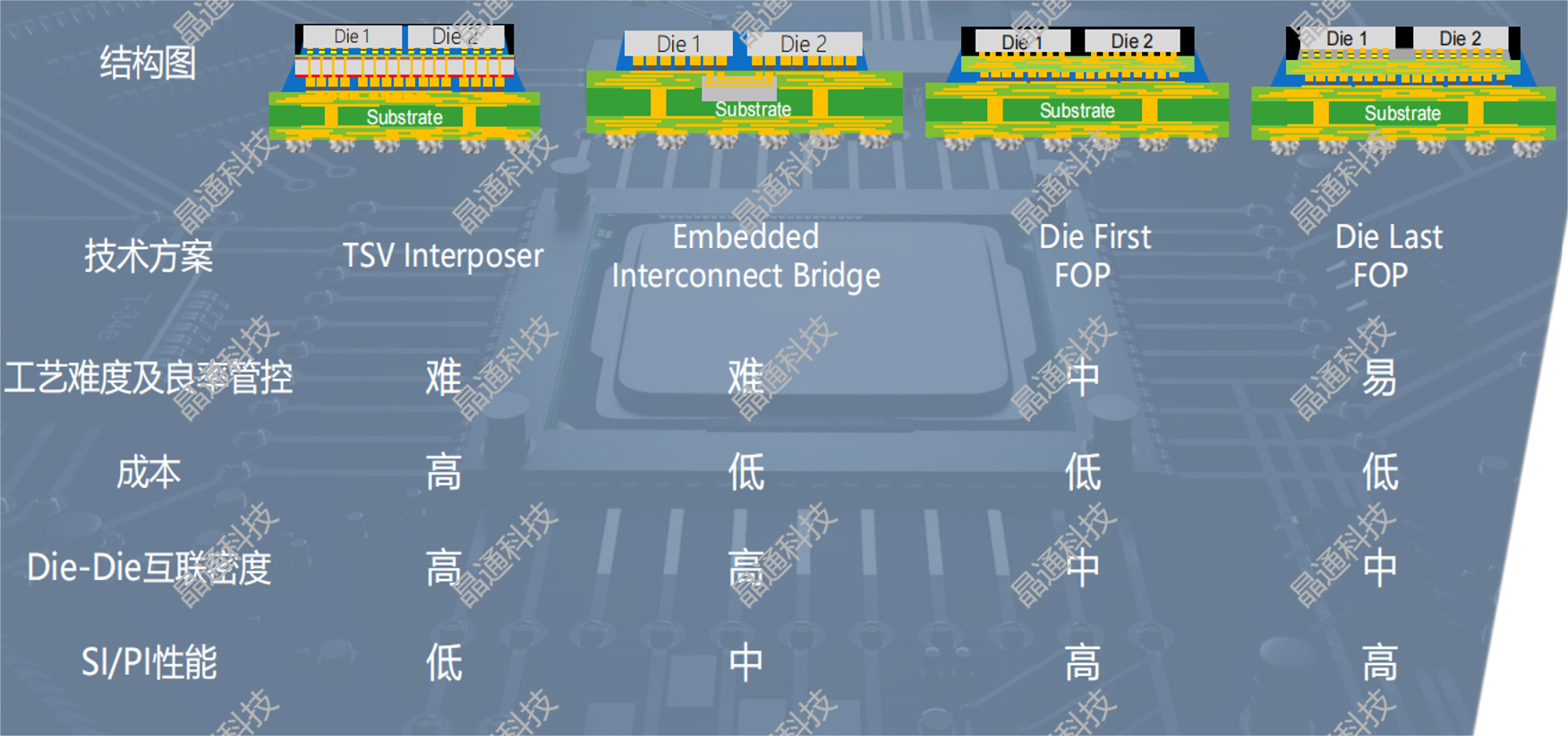
(光电合封解决方案)











